在半导体先进封装领域,晶圆凸点电镀是芯片与外部电路连接的核心环节,其质量直接决定集成电路的可靠性与性能。设备因素对电镀质量起决定性作用,本文围绕凸点应用、电镀原理展开,重点剖析设备影响因素并给出改进方案,为工艺优化提供参考。
在半导体先进封装工艺中,晶圆凸点电镀是连接芯片与外部电路的关键步骤。晶圆凸点的质量和性能直接影响整个集成电路的可靠性和性能。因此,确保晶圆凸点电镀的高质量至关重要。设备因素在电镀过程中起着决定性的作用,深入分析这些因素,为工艺优化提供参考意义重大。
(1)晶圆凸点在先进封装中的应用
晶圆凸点是先进封装中重要要素之一,它的主要作用是电气互连和应力缓冲。从传统的打线工艺发展到倒装焊接工艺,凸点起到了至关重要的作用。在先进封装技术中,凸点技术是其中的关键技术,如台积电的2.5DCoWoS技术和集成式扇出型封装(InFO)技术、英特尔的嵌入式多芯片互连桥(EMIB)和3D逻辑芯片封装技术(Foveros)、三星电子的扇出面板级封装(FOPLP)和混合基板封装(H-Cube)技术等,凸点的作用都十分重要,部分先进封装形式如下图所示。在过去的十多年间,先进封装技术快速发展,涌现出2D、2.5D、3D3D+2D、3D+2.5D等多种封装方式,应用领域包括5G、AI、可穿戴设备、高性能服务器、高性能显卡。总的来说,先进封装的目的就是提升功能密度,缩短互联长度,提升系统性能,降低整体功耗,而其中最为重要的环节之一就是凸点制备以及互联,因此凸点技术的开发与优化影响先进封装技术的发展。

由于工艺进展,凸点尺寸变得越来越小,单位面积芯片上I/O引脚数不断增加,异构集成微系统以及凸点制备工艺将呈现体积不断微型化、功能密度不断提高的发展趋势。伴随着凸点互连技术不断优化,异构集成微系统有望获得突破,并对集成电路行业产生颠覆性影响。
(2)晶圆凸点电镀技术基本原理
半导体(晶圆)电镀技术是一种在半导体制造过程中非常重要的技术,广泛应用于晶圆表面的金属化过程。凸点电镀法制作工艺一般分为基片的准备、蒸发/溅射凸点下金属层的制备、涂光刻胶、光刻电镀区图形、凸点电镀、去除光刻胶、腐蚀凸点下金属层(UBM)和回流的工艺步骤来完成。电镀技术通过电解的方式,在晶圆表面沉积一层金属,以形成所需的电路和连接。这种技术在半导体行业中扮演着至关重要的角色,对于提高半导体器件的性能和可靠性具有重要意义。
如下图所示,半导体电镀技术的基本原理是利用电解原理,在晶圆表面沉积一层金属。电镀过程中,晶圆作为阴极,金属阳离子在电场的作用下向阴极移动,并在晶圆表面还原成金属原子,从而形成金属层。通过控制电镀液中的金属离子浓度、电流密度、温度等参数,可以精确控制金属层的厚度和性能。

下图是晶圆凸点制备的典型工艺流程。
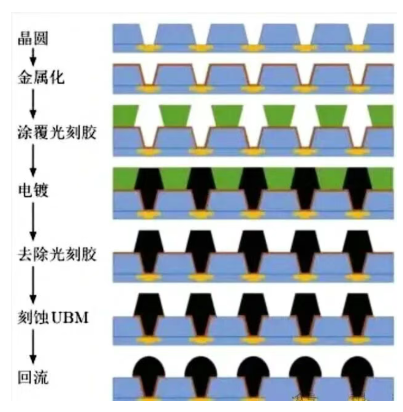
(3)影响晶圆凸点电镀质量因素分析
影响电镀质量的因素很多,包括镀液的各种成分以及电镀工艺参数。工艺是核心,设备为工艺服务。在物理因素方面,温度、压力、流速等物理参数对电镀质量的影响显著。适当的温度和压力可以提高电镀层的均匀性和附着力,而流速的控制则直接影响电镀液的分布和浓度。化学因素方面,电镀液的成分、pH值、温度等化学参数对电镀质量有着至关重要的影响。合理的化学成分和pH值可以保证电镀过程的稳定性和可控性,而温度的控制则直接关系电镀层的结构和性能。环境因素方面,洁净度、湿度、振动等环境因素也会对电镀质量产生影响。高洁净度的环境可以减少杂质对电镀层的污染,而湿度和振动的控制则可以保证电镀过程的稳定性和一致性。人工管理因素也很重要,操作人员的技能、责任心、培训等都会影响电镀质量。合理的培训和管理可以确保操作人员熟练掌握电镀技术,提高电镀质量。
一台高质量晶圆凸点电镀设备对电镀质量十分关键,电镀槽或电镀杯体、电源质量、温度控制系统、镀液循环流动设计和管控等设备的性能和稳定性对电镀质量有着直接影响。高质量的设备可以确保电镀过程的稳定性和可控性,提高电镀质量。根据QYResearch头部企业研究中心调研,全球范围内单晶圆电镀设备生产商主要包括应用材料、东京电子、Lam Research、荏原科技、田中控股等。2022年,全球前四大厂商占有大约73%的市场份额。随着国内半导体产业的发展,国产电镀设备厂商不断提升自主研发能力,逐步替代进口设备,降低成本,提高效率,增强竞争力。
(4)设备因素在晶圆凸点制备中的影响及改进
随着近年凸点工艺及设备的快速发展,凸点的制作方法种类很多。目前,应用比较多的主要有电镀法、蒸发/溅射法、化学镀法、机械打球法、激光法、置球和模板印刷法、移置法、叠层法、柔性凸点制作法和喷射法等。电镀工艺具有重复性好、一致性高的优点,同时制备工艺与IC、微机电系统(MEMS)工艺相兼容,可用于批量生产各类规格芯片及不同材料、不同高度的凸点,是当前凸点制备的主要方法之一。
采用试验与模拟相结合的方法,对不同设备因素下的晶圆凸点电镀过程进行深入研究。选择4种关键因素进行试验:电镀槽设计、电源系统、温度控制系统和电镀液循环系统。每种因素设计不同的参数组合,观察其对电镀质量的影响。通过高分辨率显微镜和扫描电子显微镜对晶圆凸点进行观察和测量,记录各项参数下的电镀效果。使用统计软件对数据进行处理和分析。
1)电镀槽设计:合理的电镀槽设计能够确保电镀液的均匀分布和晶圆的稳定放置。试验中发现,槽体的材质、形状和尺寸都会影响电镀效果。
2)电源系统:电源系统的稳定性对晶圆凸点的形状和尺寸有重要影响。不稳定的电源会导致凸点的不均匀和粗糙。
3)温度控制系统:温度是影响电镀反应速率的关键因素。适当的温度可以提高电镀效率和凸点质量。
4)电镀液循环系统:有效的循环系统可以确保电镀液的均匀分布和及时更换,从而提高电镀效果。特别是电镀液循环喷镀中的流场设计和电场的匹配研究对凸点制备的质量息息相关。喷杯体采用抽拉式的喷镀杯,方便转换。配置铂-钛网不溶性阳极,网眼尺寸为5 mm。阳极和阴极间的高度可调,喷镀杯与晶圆夹具间的溢流口可调。电镀电源导电采用铠装铂丝。喷镀时可提供连续的镀液流。各槽可独立调节加热、过滤、镀液流速及电镀电流。具有去离子水喷洗和氮气吹干功能。具有镀液连续循环过滤功能(滤芯过滤精度小于0.5 μm)。改变电镀液进入电镀杯的流速、出液口直径、匀流板的位置、匀流板的厚度、匀流板上孔的大小及分布、液流出口高度,寻求最佳配置参数。通过Fluent软件分析模型得到了提高凸点质量的最佳设备细节参数。通过改进得到了如下图所示的流场速度云图和速度矢量图效果。
确定优化后的匀流板的厚度是5mm。匀流板孔的直径是5 mm,横向和纵向孔间距是10 mm,均匀分布。匀流板距离下部的高度为10 mm。
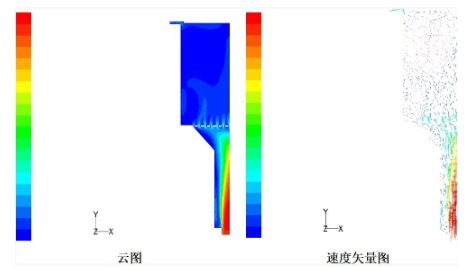
经过优化后的设备实际验证,各项技术指标已达到国外同类设备技术水平,其中,凸点均匀性等技术指标已超过同类产品。在金凸点制备的试验效果中,电镀金纯度≥99.99%,容差在圆片内达到±2.5 μm,表面粗糙度Ra<0.2 μm,剪切力>97 N/mm2,维氏硬度为81HV。
综上,晶圆凸点电镀质量关乎先进封装技术发展,设备各系统设计与性能至关重要。通过优化电镀槽、电源等关键设备参数,可显著提升凸点质量,甚至赶超国外同类设备。这为国产设备替代、推动半导体产业发展提供了有力支撑。
文章来源:电子工艺技术


Copyright © 2021 深圳市恒享表面处理技术有限公司 All Rights Reserved 备案号:粤ICP备09192382号 技术支持:易百讯 - 深圳网站建设