高深宽比硅通孔(TSV)电镀铜填充工艺研究,本文利用实验方法,进行筛选添加剂,对设备参数的优化,提出新的解决方法,我们不妨进来详细的了解一下!
作为后摩尔定律时代重要的集成技术之一,硅通孔(ThroughSiliconVia,TSV)技术目前在工业界得到了迅速的发展和广泛的应用。三维(3D)-TSV是TSV技术的核心,也是实现芯片级互联的关键。本文通过对3D-TSV电镀添加剂含量、电镀时间、扩散时间及电镀搅拌速度等工艺的研究,得到了最佳的电镀工艺参数,并获得了表面光洁均匀的镀层,实现主流孔型10μm×100μm的无缺陷填充,且在化学机械抛光(chemicalmechanicalpolish,CMP)后平整无空洞缺陷。
引言
随着人类社会信息化、智能化的迅猛发展,集成电路技术即将进入后摩尔时代[。三维集成是后摩尔时代中支撑半导体器件小尺寸化、多功能化、高可靠性的关键技术,可以将逻辑芯片、存储芯片、射频芯片和MEMS等不同功能、不同类型的芯片集成到一个系统中 。相对于传统的封装技术,硅通孔(TSV)技术有着诸如例如缩短互联长度,减小产品尺寸,降低内阻和功耗,提高芯片性能等方面的独特优势,将在三维集成工艺中发挥举足轻重的作用。 自底向上(Bottom-up)的TSV铜电镀填充技术具有沉积速度快、电镀面铜厚度低、不易出现内部空洞及缝隙等优点,同时极大程度降低了CMP后空洞缺陷及边缘分层等缺陷的出现,是最经典的TSV电镀填充工艺。图1为“自底向上”电镀工艺原理 示意图,如图所示,电镀工艺中的添加剂对TSV的填充效果起到了最直接的影响。

图1“自底向上”的电镀工艺示意图
添加剂主要包括了具有抑制作用的抑制剂,具有表面整平作用的整平剂和具有底部加速沉淀作用的加速剂,其比例浓度对TSV电镀填充效果起着决定性作用 。为了实现抑制通孔外表面沉积速度,加快通孔内部沉积速度的电镀效果,有以下两个添加剂直接相关的理论要点需要实现:1)表面抑制剂就是铜表面覆盖强吸附力抑制剂,其原子有包覆作用并对表面的铜沉积有抑制作用。此过程是一个添加剂相互协同作用的过程,在抑制剂抑制表面铜沉积的时,大颗粒的抑制剂有更强的表面抑制作用。2)加速剂也称为光亮剂是加速铜电镀沉积的作用,顶部抑制剂抑制了铜表面的沉积,而一般对于小分子的加速剂来说,小分子的加速剂在电流的驱使下,率先到达通孔底部,使铜在通孔底面的沉积速度加快,从而达到TSV孔底部优先生长的目的。而整平剂在整个电镀铜沉积过程,起到了部分的整平电镀铜的作用,使得表面镀层更加平整,利于后续的机械研磨工艺。 除此之外,电镀机台的设备性能和工艺参数,如电镀液温度、搅拌速度、电镀扩散时间等会直接导致TSV孔被填满的时间、孔内的空洞或缝隙,电镀铜层表面的粗糙程度、孔内生长均匀性等的不同 。如果不选择合适的工艺参数,最终可能导致产生诸如内部孔洞和缝隙、孔口凹陷大、面铜厚、表面粗糙和鼓包等缺陷。 本文主要研究TSV电镀加速剂,抑制剂,整平剂的含量以及电镀设备相关参数对自底向上生长模式的TSV铜充填效果的影响,对铜电镀充填机理进行分析,确定了最佳的电镀工艺条件。
1实验方法1.1实验材料 本文采用了上海新阳半导体材料股份有限公司自主研发的UPT3360(添加剂)和SYS2520(基础镀液),整个电镀过程在1L电镀槽和RAIDER电镀台内进行操作。 1.2实验步骤1)配置电镀液:在甲磺酸铜溶液中加入指定含量的加速剂A、抑制剂S、整平剂L以及浓度为55克/升的Cu离子,组成基本溶液。2)TSV电镀:对8寸晶圆片进行了10μm×100μmTSV电镀填充。在电镀过程中,使用直流恒流的电源供电,同时采用磁性搅动,在25℃的恒温下、0.1-0.24A/dm2密度内进行电镀。 3)电镀效果检测:采用电化学曲线分析、3D-X射线检测(X-RAY),光学显微镜,扫描电子显微镜(scanningelectronmicroscope,SEM),聚焦离子束(focused-ion-beam,FIB)等检验仪器对TSV填充效果进行表征。
2实验过程2.1添加剂的筛选2.1.1加速剂A的筛选 加速剂基本组成通常为二甲基二硫代甲酰胺丙烷磺酸钠(DPS)、3-巯基-1-丙烷磺酸钠(MPS)、聚二硫二丙烷磺酸钠(SPS)类的物质,其分子量比较小。图2展示了在电化学分析曲线中加速剂A的影响,加速剂在via底部的加速能力占比相对较多,随着时间及电镀镀层增长,加速剂一直起作用,只不过孔口占比相对较少,所以增长较慢;图2中的A-1曲线极化电位最弱,表示它的加速能力最弱,容易在via中下部产生空洞void,如图(e);图2中A-3极化电位最强,容易导致via提前封口如图(a);图2中A-2处于极化电位适中位置,在合适的抑制剂及整平剂的浓度下可以实现via内部完全填充,如图(b)、(c)、(d)。
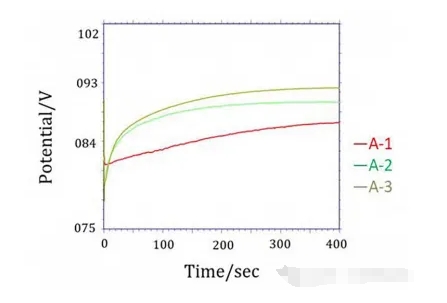
图2 加速剂A对电化学曲线的影响
除了电化学分析以外,实验也探索了加速剂A含量对电镀效果的影响。在保持抑制剂S和整平剂L含量不变的前提下,采用了控制变量法,测试了加速剂A含量不同(0.5ml/L~5ml/L)的添加剂对TSV铜电镀填充效果的影响,结果如图3所示:(a)A:S:L=0.5:5:5;(b)A:S:L=2:5:5;(c)A:S:L=2.5:5:5(d)A:S:L=3:5:5;(d)A:S:L=3:5:5;(e)A:S:L=5:5:5。从图中可以看出:当A含量在2~3ml/L范围内时(对应图3(b)-图3(d)),TSV表现为无缺陷填充;当A含量过低时(对应图3(a)),由于通孔底面处的铜沉积速度不足,因而没有形成Bottom-up的填充模式;当A含量过高时(对应图3(e)),导致表面处的抑制剂效果不足,因此也没有形成无缺陷填充效果。综上所述,加速剂A推荐值为2~3ml/L范围。
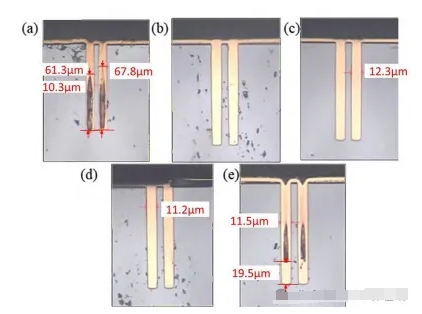
图3加速剂A含量对TSV填充影响
2.1.2抑制剂S的筛选 抑制剂通常为聚醚、聚醇类的表活(例如聚乙二醇,分子量大于6000)类物质,作用是抑制TSV孔侧壁及表面的生长,使得铜优先在孔底沉积,实现无缺陷且填孔速率较快的“自底向上”生长方式。抑制剂在via表面及侧壁抑制能力相对较多,随着时间及电镀镀层增长,抑制剂会一直起作用,这对抑制剂的润湿性要求很高,图4中S-3极化电位最弱,表示它的抑制能力也是最弱的,容易在via底部产生void,有两种解释1是润湿效果未达到图(e)wafer深度,2是抑制能力太弱,导致via底部抑制剂能力较弱产生空洞void,如图(e);图4中S-1极化电位表现最强,容易导致via内部抑制过强,导致铜离子不能正常生长如图(a);图4中A-2极化曲线表现适中,结合相对的加速剂及抑制剂可以使via内部完全填充,如图(b)、(c)、(d)。
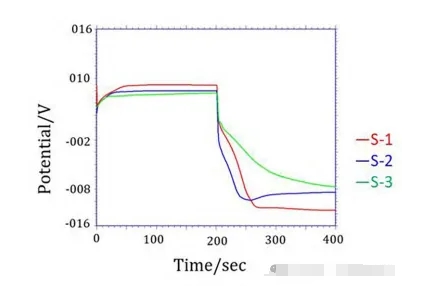
图4抑制剂S对电化学分析曲线的影响
实验也同样分析了抑制剂S含量对TSV铜填充效果的影响,在保持加速剂A和整平剂L含量不变的前提下,抑制剂S含量在1ml/L到10ml/L范围内设置了5组对照组,分别表征了各组TSV电镀填充效果,结果如图5所示:(a)A:S:L=2.5:1:5;(b)A:S:L=2.5:4:5;(c)A:S:L=2.5:5:5;(d)A:S:L=2.5:6:5;(e)A:S:L=2.5:10:5。从图5可以看出抑制剂S含量在4~6ml/L范围内时,如图5(b-d),表现为无缺陷填充;当S含量过低时,如图5(a),无法起到抑制孔侧壁和表面的生长,使得填充效果不理想;当抑制剂过S含量过高时,如5(e)图所示,导致加速剂效果减弱,无法形成自底向上的填充模式,出现缺陷。因而抑制速剂S推荐值为4.5~5.5ml/L范围。
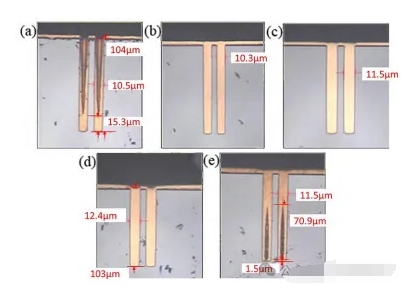
图5抑制剂S含量对TSV填充影响
2.1.3整平剂L的筛选 整平剂L通常为聚乙烯亚胺盐类的、EO-PO季胺盐类、聚乙烯亚胺季胺盐类的、聚胺类的物质。在TSV电镀填充过程中,主要起到的作用是,抑制via面铜、via孔口侧壁铜沉积的作用,通过合适的浓度控制下可以使孔口微凸、平整或dish等不同形貌的镀层,以便于后续的化学机械研磨。 整平剂主要吸附在via表面及via孔口处,随着时间及电镀镀层增长,整平剂会一直起作用,这对整平剂的吸附要求很高,图6中L-1极化电位最弱,表示它的吸附能力也是最弱的,容易在via中部产生空洞void,如图(e);图6中L-2极化电位表现适中,但是缺少侧壁吸附能力,容易导致在特定的电镀时间里,使铜离子不能正常生长如图(a)镀速偏慢的现象;图6中L-3极化曲线表现最强,结合相对的加速剂及抑制剂可以使via内部完全填充,整平剂较强的情况下,可以更好的辅助加速剂在短时间内快速填充,如图(b)、(c)、(d)。
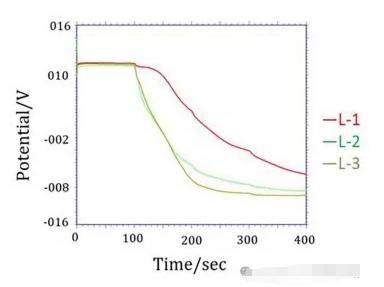
图6整平剂L对电化学曲线的影响
在保持加速剂A和抑制剂S含量不变的前提下,整平剂L含量从1ml/L到10ml/L范围内设置了5组对照组,表征了各组TSV电镀填充效果,用来分析整平剂L含量对TSV填充的影响,结果如图7所示:(a)A:S:L=2.5:5:1;(b)A:S:L=2.5:5:4;(c)A:S:L=2.5:5:5;(d)A:S:L=2.5:5:6;(e)A:S:L=2.5:5:10。从图7可以看出,整平剂L含量在4~6ml/L范围内,如图5(b-d),表现为无缺陷填充;当L含量过低时,如图7(a),整平剂无法起到表面整平抑制效果,无法完整填充TSV孔口;当整平剂L含量过高时,如图7(e)所示,因抑制剂侧壁抑制效果减弱,从而形成了孔洞。因而整平剂S推荐值为4~6ml/L。
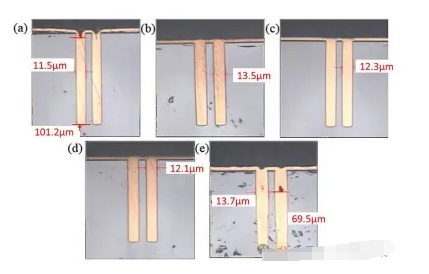
图7整平剂L含量对TSV填充影响
2.2电镀工艺参数对电镀TSV填充效果的影响 2.2.1电镀液温度的筛选 本文在不同电镀液温度下进行了TSV铜电镀填充实验,结果如图8所示。当电镀液温度为20℃时,填充完整无缺陷,面铜厚度为2.2μm;25℃时,填充完整无缺陷,面铜厚度为2.2μm面铜;30℃时,填充完整无缺陷,面铜厚度为2.3μm,电镀速度略快,口部有缩小趋势。实验结果表明,电镀液温度在20℃~30℃时,电镀填充效果正常,温度在此范围内对填充效果的影响较小,温度窗口较宽,建议使用温度为25℃。

图8 电镀温度对TSV填充的影响
使用电镀磁力搅拌器,对电镀过程中的电镀液进行搅动,可以使得电镀液与添加剂在溶液中得到了充分的融合,影响电镀效果,故本文探究了搅拌速度对TSV铜电镀填充效果的影响,结果如图9所示。当搅拌速度为50RPM的旋转,通孔填充完整且无瑕疵,但孔内镀速偏慢,面铜厚度为2.2μm;转速改为500RPM,TSV孔填充完整且无瑕疵,镀速正常,面铜厚度为2.1μm;转速为1000RPM,填充完整且无瑕疵,镀速偏慢,面铜厚度为2.1μm。因此,不同转速条件的结果表明,50RPM~1000RPM下都能无缺陷填充,有着较宽的工艺窗口,但不同搅拌速度下TSV孔口镀速略有不同,导致面铜厚度不同。
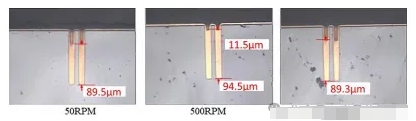
图9搅拌速度对TSV填充的影响
然而转速对填孔速度的影响更大,过低过高的转速会使孔内的填孔速度变慢。原因是当电镀液转动过慢时,电镀液无法及时均匀分散导致填孔速度变慢;而电镀液搅拌速度过快,也会造成添加剂来不及扩散至孔的各个沉积部位(比如抑制剂无法有效地附着在孔侧壁及表面),导致表面铜厚增加而孔内的填孔速度不足。与此同时,过快的表面铜沉积也会导致表面铜结晶变粗,不利于后续的CMP制程工艺,给研磨带来更加困难。因此,在实际情况,大多会结合使用效率和节能的角度看,通常选择速度较快,且面铜平整较薄的电镀搅拌器速度,这样既满足了填充效果更好,也提高了生产效率。最终获得有利于产业化的方向发展。2.2.3扩散时间的筛选 在TSV电镀早期阶段,为让添加剂与电镀液相结合并能充分润湿通孔,会在电镀前加一步小电流扩散。通过固定该步骤的扩散电流密度为0.02ASD,设定不同的扩散时间来分析这一步骤对填充效果的影响,结果如图10所示。当扩散时间为1分钟时,中下部会有小seam-void,面铜厚度为2.1μm;扩散时间为5分钟时,填充完整无缺陷,面铜厚度为2.1μm;扩散时间为10分钟时,填充完整无缺陷。综上所述扩散时间在5分钟~10分钟内均可实现无缺陷填充。从节能考虑扩散时间推荐为5分钟。
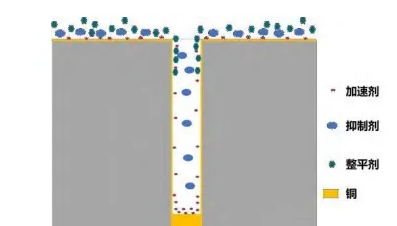
图10扩散时间对3DTSV填充的影响
2.3优化组合条件 通过以上实验筛选,选择的较优工艺条件如下:添加剂浓度比例为加速剂UPT3360A=2.5ml/L、抑制剂UPT3360S=5ml/L、整平剂UPT3360L=5ml/L,电镀温度设定25℃,1000RPM的搅拌速度以及5分钟的扩散时间,电镀填充效果如图11所示,实现无缺陷且填孔速率较快的“自底向上”生长方式。
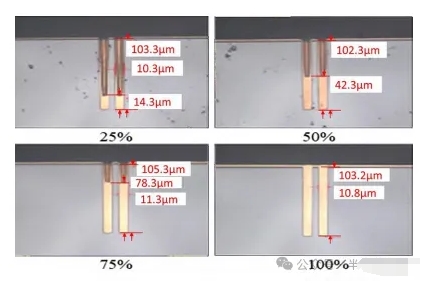
图11 TSV填充趋势图
图12是TSV铜电镀表面结果,可以看出表面平整光洁,没有明显的缺陷。除此之外,X-ray结果如图13(a)所示,可以看到电镀后晶圆的整体均匀性依然较高;退火后填充效果及结晶如图13(b)的FIB结果所示,化学机械研磨抛光后的效果如图13(c)所示,无分层,无表面孔洞等缺陷。可达到工业化生产要求。
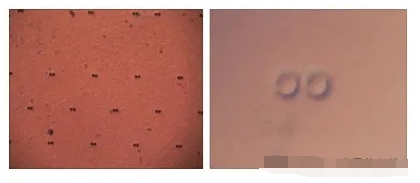
图12 电镀铜表面检查
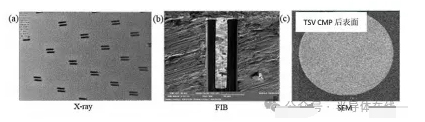
图13电镀效果
3结论综上所述,通过对TSV电镀铜添加剂配比及其设备参数等工艺研究,找到对于10×100μm的TSV铜电镀的最佳工艺参数,并通过了后道CMP制程的考验,为实际工业化生产提供了解决方案。然而对于集成电路的更高集成化发展需求,更高的纵深比的TSV孔的无缺陷填充也是必须要迫切解决的发展方向。而对于TSV产业化发展,未来仍面临均匀性的挑战,因此势必要更加深刻地理解和创造更好的添加剂以及对材料物质的优化组合,并配合后段工艺需求,为整个集成电路行业发展提供新的发展空间。
高深宽比硅通孔(TSV)电镀铜填充工艺研究是后摩尔定律时代重要的集成技术之一,对于实现芯片级互联和提高电子器件性能具有重要意义。以下是对该工艺的详细研究。
文章来源:半导体材料与工艺 图文来自网络,仅用于行业学习交流,版权归原作者所有,如有侵权,请联系我们删除


Copyright © 2021 深圳市恒享表面处理技术有限公司 All Rights Reserved 备案号:粤ICP备09192382号 技术支持:易百讯 - 深圳网站建设